
КДПВ справа – миниатюрная камера (62.5 тыс. пикселей), ставшая возможной благодаря соединению с оптическим сенсором через TSV
В одном из предыдущих постов, я рассказывал о том, что же такое трёхмерная интеграция и как эта технология могла бы продлить жизнь кремниевой электроники за счет роста в третье измерение. В этот раз я постараюсь описать известные мне проблемы этой технологии, из-за которых сейчас и в ближайшие несколько лет в магазинах не появятся «многоэтажные» микропроцессоры и память нового поколения. Аргументированно ругать всегда проще, чем хвалить :). Итак…
Для начала – об изготовлении отверстий в кремниевой пластине. Толщина кремниевых пластин, используемых для литографии, варьируется от ~20 и до ~800 мкм. При этом нижний слой обычно находится в категории >250мкм, а остальные в категории <60 мкм. На то есть ряд причин, в том числе и механическая прочность. Так вот, остро стоит проблема, как изготовить множество аккуратных отверстий в слое кремния толщиной даже 20 мкм, и при этом не повредить саму пластину (на ней уже находятся или будут находиться транзисторы на три порядка меньших размеров). Существует несколько технологий, для изготовления отверстий и традиционно стоит выбор между аккуратностью и скоростью, а значит – ценой. Приведу несколько изображений.
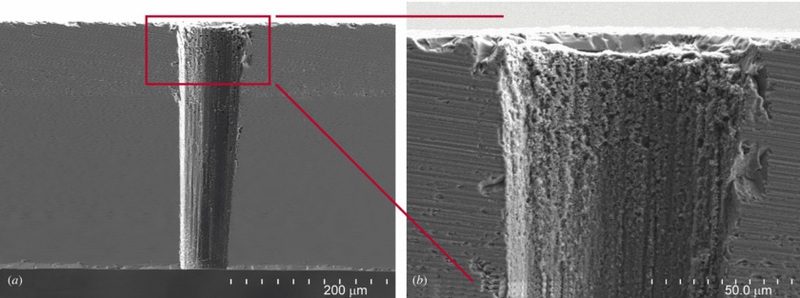
Отверстие, полученное с помощью лазерных импульсов (40нс, 100КГц) (9400 шт./19 мин.)
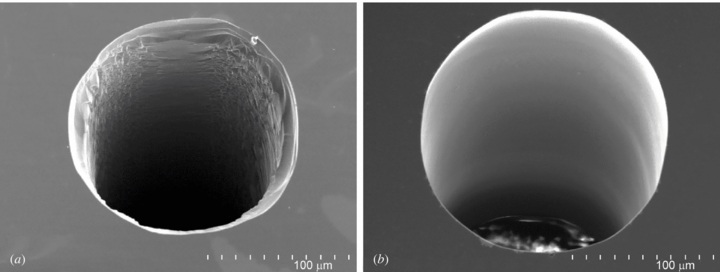
Результаты химического травления отверстий прорезанных лазером (20мин./пластина)
Следующий шаг – это металлизация отверстий. Тут тоже есть ряд своих проблем.
Первое – размеры TSV, и транзисторов отличаются на 2-3 порядка, поэтому, если пытаться перенести в отверстие такое количество металла теми же способами, то это будет долго. Вернее, ДОЛГО, и дорого.
Второе, из-за того, что металл надо наносить не на плоскую поверхность, а на внутренние стенки отверстия, отверстия имеют тенденцию «заростать». То есть, металл полностью закрывает входное отверстие, так и не покрыв полностью его стенки и не создав сквозной проводящей связи. Для решения этой проблемы надо прилагать дополнительные усилия.
Есть интересные подходы, вроде «забивания» в отверстия металлического штифта, с очевидными проблемами, как из разряда точности операций, так и сохранности пластины.
Далее – проблемы сборки стека кремниевых пластин с использованием TSV (вертикальных соединений). 3d-интеграция в первую очередь важна для больших устройств, т.к. могла бы сильно снизить их стоимость, сократив площадь кремниевой пластины, отбраковываемую одним единственным дефектом. Но вместо этого проблема видоизменяется: теперь при укладке одной пластины на другую требуется соединить друг с другом сотни и тысячи TSV контактов. Причем сделать это с первого раза, второй попытки не будет. Подобные упражнения при размерах TSV порядка единиц или десятков микрон лежат в области точной механики, у которой есть свои ограничения. А цена ошибки – брак всего стека пластин. Что не отразится положительно на цене.
При этом, вокруг TSV при разработке необходимо оставлять некоторую «зону отчуждения», свободную от транзисторов. Иначе слишком высок риск, что, в процессе прорезания отверстий или сборки стека пластин, логика в данной области будет повреждена. Это с одной стороны увеличивает занимаемую площадь, а с другой – требует учитывать подобные вещи в ходе проектирования.
Механическая прочность такого изделия – отдельная проблема. Наличие сквозных отверстий само по себе снижает прочность пластин. Кроме того, из соображений распределения нагрузки, отверстия лучше бы располагать равномерно. Также, такой «бутерброд» из кремниевых пластин будет иметь неравномерные характеристики теплового расширения. При перепадах рабочей температуры это создает значительное усилие в точках соединения TSV и может привести к разрушению стека.
Но основной проблемой, конечно, является поддержание температурного режима. Для того, чтобы обеспечить температуру ниже 80 градусов приходится идти на различные ухищрения. Например, специалисты из IBM предлагают чередовать кремниевые пластины с пластинами, обладающими высокой теплопроводностью, создавая своего рода «проникающий радиатор», который отводит тепло эффективнее, чем только соприкасающийся с поверхностью.
В теории, нет никаких ограничений на то, какое количество пластин можно объединить, используя 3d-интеграцию. Но, даже для памяти, где проблема с тепловыделением не стоит столь остро, планы на будущее ограничиваются восемью слоями.
Температурный режим также является причиной, почему технология 3d-интеграции находилась за пределами интересов Intel, несмотря на то, что ряд других компаний в индустрии её активно развивали и пытались использовать. До сравнительно недавнего времени рынок мобильных устройств не являлся приоритетным, и все усилия были направлены на создание настольных и серверных процессоров. При этом, основной целью был рост производительности, а не снижение энергопотребления. Наибольшую выгоду можно было бы получить, применяя 3d-интеграцию к большим чипам, вроде того же Itanium. Но температурные проблемы этому активно мешают.
Интересной проблемой в некоторых случаях может стать тестирование и отладка подобных устройств. Представьте себе разделение на пластины не как «процессор отдельно, память отдельно», а что-то более интересное, где каждая пластина не является полноценным устройством и не работает отдельно от остальных. В такой ситуации возникнет вопрос, как проверить функционирование каждой пластины до объединения в стек? Если отказаться от такой проверки, то к вероятности того, что конечное устройство не будет работать из за ошибок соединения пластин добавится вероятность того, что одна из пластин не будет функционировать.
Ну и последнее, по порядку, а не по важности. Разработка устройств с использованием 3d-интеграции требует соответствующей поддержки средствами автоматизации проектирования. Ряд компаний озаботился этим уже давно, в частности, Synopsys ведет работу в этом направлении, по крайней мере, с 2009го года. Но это долгий процесс. Усилия здесь не ограничиваются человеко-часами разработчиков, и еще многое предстоит сделать.
На этом я закончу. Огромное количество более специфических проблем вряд ли представляет интерес для широкой общественности. Да и написанного выше должно быть достаточно для понимания того, что 3d-интеграция не «серебряная пуля» и на пути к ней лежит множество проблем.
Возможно, будет еще один пост, посвященный ряду экзотических применений технологии 3d-интеграции.